Статья опубликована в рамках: V Международной научно-практической конференции «Инновации в науке» (Россия, г. Новосибирск, 12 декабря 2011 г.)
Наука: Технические науки
Скачать книгу(-и): Сборник статей конференции, Сборник статей конференции часть II
- Условия публикаций
- Все статьи конференции
дипломов
Обзор Методов ПОВЫШЕНИЯ РАЗРЕШАЮЩЕЙ СПОСОБНОСТИ ПРОЦЕССА фотолитографии при создании топологии микроструктур субмикронного производства ИМС
Захаревич Андрей Анатольевич
аспирант, кафедра ЭТТ БГУИР, г. Минск
Е-mail: AndyZahar@yandex.ru
Достанко Анатолий Павлович
д-р. техн. наук, профессор БГУИР, г. Минск
Степень минимизации элементов ИМС, а соответственно и разрешающая способность объектива оборудования мультипликации (степперы и сканеры) зависит от множества факторов, таких как числовой апертуры (NA) объектива, дифракции света на элементах фотошаблона, длинны волны экспонирующего излучения и т. д.
Формирование элементов рисунка на поверхности пластины покрытой резистом, приобретает большие сложности, когда его размер оказывается меньше длины волны экспонирующего излучения. В соответствии с эмпирическим критерием Релея, разрешение проекционной системы R определяется дифракционным пределом:
![]()
где l – длина волны экспонирующего излучения (li-line = 365 нм), NA – числовая апертура проекционной системы объектива, а коэффициент К определяется уровнем технологии конкретного производства.
Оптимизация разрешающей способности происходит за счет использования более коротковолнового экспонирующего источника излучения или изменения числовой апертуры объектива. Однако это приводит к существенному уменьшению значения глубины фокусировки Δz (или DOF, depth of focus), которая обратно пропорциональна квадрату числовой апертуры NA:
![]()
где К – технологический коэффициент (К>1), l – длина волны экспонирующего излучения (li-line = 365 нм), NA – числовая апертура проекционной системы.
В основном, фотолитография в качестве источника УФ излучения использует ртутные газоразрядные лампы, отсекая из их света всё, кроме нужной длинны волны, совпадающей с одним из пиков (линий спектров излучения) — g (436 нм), h (405 нм) или i (365 нм).
Размеры минимального элемента транзистора ИМС, уменьшаются прямо пропорционально длине волны экспозиции, поэтому потребовалось внедрить другой источник излучения – эксимерный лазер, который в зависимости от газа даёт длину волны 248 нм (KrF), 193 нм (ArF) и 157 нм (F2) и получил название DUV (Deep UltraViolet — глубокий ультрафиолет).
Совсем недавно был разработан малогабаритный источник предельного ультрафиолета, принцип работы которого основан на использовании излучения из лазерной плазмы т. е. EUV (Extreme Ultra Violet) с длиной волны 10 – 14 нм. Излучение стандартного твердотельного Nd:YAG лазера (длина волны - 1064 нм, мощность – 40 Вт, частота – 100 Гц) фокусируется на импульсной газовой струе Xe кластеров. Образующаяся лазерная плазма содержит широкую спектральную полосу предельного ультрафиолета с λ~10-25 нм. Поскольку EUV-излучение хорошо поглощается стеклом, новая технология предполагает использование серии из четырех специальных асферических зеркал, которые уменьшают и фокусируют изображение, полученное после применения маски. Каждое такое зеркало содержит около 80 двухслойных пленок с толщиной каждого слоя ~ λ/4 и размером неоднородностей ~10 Å. Схема установки приведена на рисунке 1.
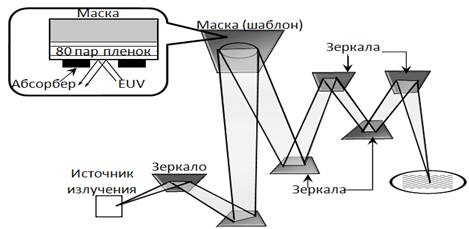
Рисунок 1– Схема установки EUV литографии.
Если принять во внимание двадцатикратное снижение длины волны (от 248 до 10 нм), то переход к EUV литографии позволит перейти на новый рубеж уменьшения размеров элементов, т. е. менее 30 нм, оставаясь в рамках традиционной фотолитографии.
Основной проблемой получения субмикронных размеров с использованием проекционной литографии является дифракция света на элементах шаблона, которые расположены на расстояниях порядка длины волны экспонирующего излучения.
В обычных шаблонах после дифракции на соседних элементах синфазные волны интерферируют и частично засвечивают фоторезист в областях между рассматриваемыми элементами. При уменьшении размеров элементов это приводит к тому, что плотно упакованные элементы не прорабатываются по резисту.
Для устранения этого эффекта и повышения разрешения, некоторые производители оборудования проекционной печати (ASML, Nikon и Canon) ввели дополнительные оптические системы внеосевого освещения внутри установок, такого как анулярное, квадрапульное, дипольное и т. д.
Световая волна, проходя через шаблон, дифрагирует с образованием четных и нечетных дифракционных порядков, в случае решетки с равными по ширине линиями и зазорами образуются только нечетные порядки (рисунок 2).
При уменьшении периода дифракционной решетки, угол ß увеличивается, и меньшее количество дифракционных порядков попадает во входную апертуру проекционной линзы. Чтобы получить качественное изображение, необходимо чтобы во входную апертуру попали 0-й и ±1-е дифракционные порядки. Интерференция этих 3-х лучей при обычном типе освещения определяет полную информацию об изображении, 0-й порядок содержит информацию о распределении интенсивности, а ±1 порядки – информацию о пространственном распределении этой интенсивности (изображении). Значение глубины фокусировки проекционной системы сильно зависит от значения разности световых путей лучей 0-го и ±1-го порядков.
В случае анулярного освещения (рисунок 2) световая волна падает на шаблон под углом. После дифракции положение 0-го порядка смещается, и во входную апертуру попадают 0-й и -1 порядок падающего под углом справа потока, и 0-й и +1 слева. В этом случае наблюдается интерференция 2-х лучей 0 и -1 или 0 и +1 порядков, в результате повышается разрешение (вместо угла ß получаем ß/2) и глубина фокусировки (световые пути лучей 0 и ±1 порядков практически равны).

Рисунок 2 – Сравнение типов источников УФ освещения
Для устранения дифракции света на элементах шаблона применяют так же фазосдвигающие шаблоны и метод двойного впечатывания.
Метод двойного впечатывания подразумевает разделение топологии критических слоев СБИС на два шаблона для поочередного впечатывания, с целью частичного избавления от нежелательной дифракции. Также для ослабления действия дифракции, плотно упакованные линии впечатываются через одну. Применение двойного впечатывания позволяет существенно улучшить разрешение проекционной литографии.
Еще один метод уменьшения размеров элементов ИМС — иммерсионная литография. Суть ее в том, что пространство между объективом и экспонируемой пластиной заполняется не воздухом, а жидкостью (на данный момент — водой). Это улучшает разрешение на 30–40% ввиду большего преломления жидкости. Вода вполне прозрачна на 193 нм и имеет при этом коэффициент преломления n=1.44. Соответственно, длина волны эксимерного лазера в иммерсионной среде составит не 193 нм, а 134 нм. Числовая апертура объектива может быть сосчитана как NA = nsinα. Близкая к пределу наилучшая полученная величина числовой апертура изображающего объектива на воздухе NA0, составляет сегодня 0,95, что с водяной иммерсией даст NA = nNA0 , или 1.368,.
Intel внедрила иммерсионную литографию вместо обычной с техпроцесса 32 нм, а AMD — ещё с 45 нм.
Список литературы:
1.Родионов И.А. Исследование влияния параметров технологического процесса фотолитографии на минимальные критические размеры элементов, получаемых на кремниевой пластине. // 9-ая Молодежная научно-техническая конференция «Наукоемкие технологии и интеллектуальные системы 2007». 18 апреля 2007 г. – М.: издательство МГТУ им. Н.Э. Баумана, 2007, с. 219-224.
2.Scotten W. Jones Photolithography // IC Knowledge LLC, feb.2008, 112 p.
дипломов

